【T3STER】采用热瞬态测试界面法测试70μm Ga2O3肖特基势垒二极管,成功验证热性能
日期:2023-11-01
| 论文来源:IEEE ELECTRON DEVICE LETTERS
| 作者:Hehe Gong,Feng Zhou,Xinxin Yu,Weizong Xu,Fang-Fang Ren,Shulin Gu,Hai Lu,Jiandong Ye,Rong Zhang
| 单位:南京大学电子科学与工程学院
| 点击官网主窗口“资料中心"获取论文英文全文,文章仅供学习交流使用
Ga2O3功率器件散热挑战
氧化镓(Ga2O3)作为一种“超宽禁带半导体”材料,具有优异的物理性能。然而,Ga2O3功率器件的弱点在于导热率低,散热性不佳,这将影响器件稳定性。
针对氧化镓散热问题,南京大学电子科学与工程学院的团队发表论文《70-μm-Body Ga2O3 Schottky Barrier Diode with 1.48 K/W Thermal Resistance, 59 A Surge Current and 98.9% Conversion Efficiency》,在实验中采用衬底减薄工艺,将热阻降低到1.48 K/W,将浪涌电流增加到59 A,并将功率转换效率提高到创记录性的98.9%,显著提升其电热耐用性。
论文中,借助半导体热特性测试仪Simcenter T3STER,采用双界面法测得其器件的热阻值,验证了通过减薄衬底工艺获得的70微米厚Ga2O3肖特基二极管散热能力更强,在热管理方面有显著优势。Simcenter T3STER设备具有超强信噪比、高精密度,测试功率范围广等特点,能够对器件结温、半导体器件热阻和热容、热瞬态曲线、半导体器件封装内部结构进行测量、检验与分析。
测试过程简述
作者使用Simcenter T3STER基于电学法的热瞬态测试技术来研究SBD的结壳热阻。具体步骤是:
1、标定K系数:测试电流选择为10mA,标定结果如图4(a)所示。
2、利用瞬态热测试界面法(TDIM)来测试结壳热阻,具体方法在下文中进行阐述。
.png)
(a)Ga2O3器件的k系数曲线
(b)热阻抗曲线
(c)不同占空比的脉冲热阻
瞬态热测试界面法TDIM介绍
瞬态热测试界面法(TDIM-Transient Dual Interface Test Method)——2005年由Micred与infineon 联合向JEDEC组织提出,于2010年11月通过并正式颁布,是JESD51-14规定的结壳热阻最新测试方法。
01 测试方法
同一个器件在两种不同的热环境下测量。
第一次测量时,待测器件直接与冷板直接接触,不涂导热硅脂;
第二次测量时,待测器件与冷板之间通过导热硅脂接触。
两次测试结果在结构函数上存在重合部分,重合部分即为物理结构上从结到外壳的区域,是为结壳热阻。
.png)
.png)
02 对比传统结壳热阻测试方法的优势
传统测试方法存在以下问题:
1)结果准确性受限于测试夹具:热电偶放置的位置没有接触到器件外壳,得到的结壳热阻值偏高;
2)测试重复性差:器件外壳的温度分布不均匀,热电偶放置的位置不同导致结壳热阻值不同;
3)对功率模块封装不适用:功率模块均为多芯片封装,热电偶应该放置在什么位置?
与传统的测试方法相比,最新的热瞬态测试界面法(Transient Dual Interface)具有更高的准确性和可重复性,而Simcenter T3STER是目前唯—满足此标准的商业化产品。通过这种高重复性的方法,可以方便地比较各种器件的结壳热阻,而且这种方法同样适用于热界面材料(TIMs)的热特性表征。
03 测试结壳热阻
根据JESD51-14的规定,Simcenter T3STER支持分别使用:A、ZθJC曲线的分离点 B、利用积分结构函数曲线的分离点两种方法来计算器件的结壳热阻。
.png)
利用ZθJC曲线的分离点计算结壳热阻
.png)
利用积分结构函数曲线的分离点计算结壳热阻
如您对T3STER SI 半导体热特性测试设备及其他热仿真与热测试产品和解决方案感兴趣,请联系我们。
欢迎关注 上海坤道 SimuCAD 公众号,我们将为您带来最新产品资讯和专业的解决方案。
.jpg)
联系我们:
电话:021-62157100
邮箱:marketing@simu-cad.com
官网:http://www.simu-cad.com
哔哩哔哩:上海坤道SIMUCAD








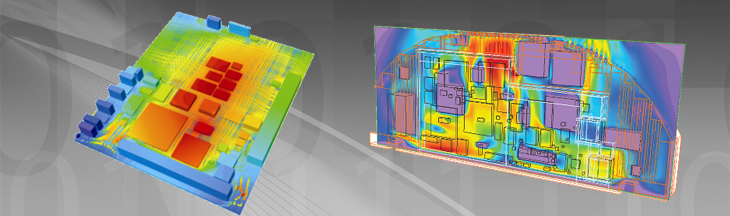

 沪公网安备 31010602003953号
沪公网安备 31010602003953号