调整风冷电子产品设计过程中的热设计策略
日期:2012-06-20
如果遵从热设计的基本原则进行设计,经过热设计之后的电子系统性能更好、可靠性更高,并且使用寿命更长。
作者:
Byron Blackmore, Mentor Graphics Corp. Mechanical Analysis 部门FloTHERM.PCB产品经理, 在加拿大Technical University of Nova Scotia获得机械工程学士学会,在加拿大University of Alberta获得传热工程硕士学位。
Robin Bornoff, Mentor Graphics Corp. Mechanical Analysis 部门FloTHERM和FloVENT产品市场经理,1992年在英国Brunel University获得机械工程学士学位,并于1995年继续攻读了该校计算流体力学博士学位。
John Parry, Mentor Graphics Corp. Mechanical Analysis 部门研发经理,他在英国University of Leeds获取化学工程一级荣誉学士学位,之后在英国Birmingham University 获取博士学位。
热设计方面有两条基本原则:尽早尽简。由元件结点至环境的热流通路(译注:也称热阻)决定了元件的温度,其中环境通常是指局部环境的空气温度。因此元件温度的控制属于系统设计层面的问题。在产品热设计过程中工程师应采用自上而下的方法来提升产品的可靠性(见下表)。

手工计算
热交换过程广泛地存在于管内自然或强迫对流流动、气体外掠平板等其它现象中。由于热交换的计算关联式很难给出比较精确的计算结果,并且使用时候很容易出现错误,所以通常情况下我们建议使用一些经验的数据1。
一块0.2m水平放置的平板,在自然对流情况下其与空气的对流换热系数大约为5W m-2K,在空气流速3 ms-1强迫对流情况下其与空气的对流换热系数大约为15W m-2K。为了考虑辐射换热的影响,我们建议自然对流的对流换热系数可以认为是10 W m-2K,强迫对流的对流换热系数可以是10~20 W m-2K。
首先,对于密闭的系统而言我们需要计算系统内的空气温度,对于强迫对流的系统而言可以假设进出口的温升为10~15°C,由此计算出强迫对流系统所需的空气流量。其次,计算所得的空气温度可以用于PCB板温度的计算。最后,通过类似Rjc等元件热阻计算元件的结温。
对于简单的系统,元件结点至环境的热阻可以认为是元件至PCB板、PCB板至内部空气、内部空气至环境的三部分热阻之和。对于复杂的系统而言,元件结点至环境的热阻需要采用热阻网络模型,这需要比较丰富的经验,能够对热阻网络模做出一些假设,并且计算相应的热阻值。
热交换过程通常都是三维的,所以手工计算或经验数据都有很大局限性。实际上由于热源分布和气流流动地不均匀性,PCB板上的温度并不一样。因此,手工计算和经验数据最大的缺点是无法对系统散热性能的改善提供帮助。
计算流体力学
我们建议采用自上而下的方法,在设计的早期阶段建立整个系统简单的计算流体动力学模型(CFD):
通过三维动态粒子流和可视化温度平面可以提供系统散热性能方面的信息
在设计周期的早期探讨不同的散热方案
将其作为设计发展过程中整合信息的平台
随着热仿真模型的细化,增强设计的可行性
概念设计
概念设计阶段的时间非常短,有时仅需几天时间。CFD软件也必须转换角色,在很短的时间内进行建模和获取仿真结果。CFD软件将系统剖分成很多网格,并在这些网格控制体内计算流动和热交换的基本方程。每一个网格都具有相应的温度、空气流速和压力值。
要使CFD工具在概念设计中起作用,其网格必须100%可靠,并且不需要用户个人控制网格质量和密度。这种趋势导致那些使用自动网格技术的通用CFD工具在电子散热软件领域无所作为。
这个阶段的设计重点是分析热量从系统中去除的基本原理。对于空气冷却的电子产品而言,这个阶段的目标是估计系统所需的空气流量。那么,模型应该包含哪些元件呢?
首先是采用一个简单的箱体来描述电子产品的外壳,其中通风孔采用2维的简化模型来描述。二维简化模型的特性应由通风孔的开孔率和损失系数所确定。专业的电子散热CFD软件应具备定义通风孔直径、角度以及分布的功能。
另外,产品内部的EMC屏蔽网也应考虑在内。在某些情况下强迫风冷系统中自然对流也会影响空气流动,所以在这些系统中需要包括浮升力的影响。此外,考虑浮升力的影响不应延长热仿真所需的时间。
鉴于轴流风扇的成本比较低,所以在强迫风冷的设备中普遍都是用这类风扇。由于在概念设计阶段主要关注的是风扇的性能是否达到要求,所以一个二维形状的轴流风扇足以满足要求。但值得注意的是,风扇至少设置为线性特性曲线,而非固定流量。
一般而言,电子产品建议采用抽风的方式,因为这样可以在系统内产生比较均匀的气流。抽风的弊端是风扇的工作温度比较高,影响风扇的寿命。
对生产商而言,使用便宜、小体积的风扇是非常具诱惑力的。但这通常不是一个好的选择,因为风扇工作在它的最大流量附近,此时噪音更大,并且风扇可靠性也下降。相反,应使用最大流量比系统散热所需空气流量大两至三倍的风扇,并且降低风机转速。
设计师应考虑电子产品中一切导热的元件,包括电子产品的外壳。PCB板可以采用一个各向同性的导热块来描述,其热导率根据PCB含铜量来确定, 约为5~10 Wm-1K-1。同时确定所有PCB板的散热量之和应等于系统的总热设计功耗。整个建模过程应在一个小时内完成,并且以更少的时间完成求解。
尽管热仿真结果是近似值,但仿真结果可支持先期的手工计算,并提供系统级气流情况的相关信息。使用元件?JB热阻值可以估计元件的温升。
模块化设计
热仿真可以进行模块化设计,这些模块化设计可以是帮助确定PCB和夹层板或元件之间气流变化的影响。
在确定产品框架结构之前,尝试可行的散热方式可以大幅的降低产品的散热成本,并且深入了解产品的散热机理。尽管这一阶段的热设计工作都是推测性的,但是这一阶段的工作相当重要。
最优散热方式取决于系统的特点。因此,热设计工程师的职责非常清晰:在结构设计完成前尽量可能多的尝试不同的散热方案,保证尽早选取最优方案。
系统温度似乎过高并不一定意味着系统需要安装风机。也许还有更好的处理方法,比如为一个或者多个元件添加散热器,或者在外壳和元件之间添加导热填充材料,使外壳具备散热器的作用。热设计工程师的工作是确定允许的元件温升,并为元件温升提供足够安全的余量。
在结构设计阶段,细化诸如PCB和元件等仿真模型中有显著温升的地方(Fig. 1),以便进行精确地求解。随着结构设计的推进,需要对元件的热功耗和所需的散热器进行估算。
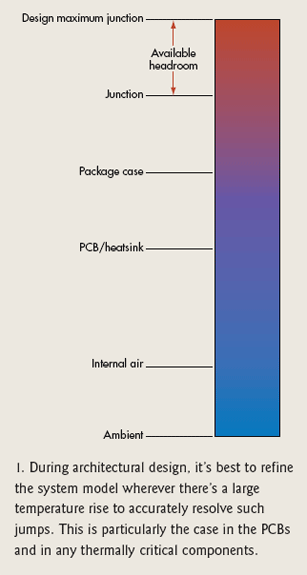
最简单的元件建模方法是采用一个具有热导率的块来描述高功耗、高功率密度和对温度敏感的原件。对于塑料封装的原件,块的热导率约为5 Wm-1K-1。对于陶瓷封装的元件,块的热导率约为15 Wm-1K-1。可以将一些已知热功耗但并不重要的元件作为平面热源,它们所产生的热量将直接进入PCB。
在结构布局完成之前很难获得元件的位置,但设计工程师最好猜想哪一种布局会首先得到尝试。“What-if”分析将在后期的工作中节省热分析工程师和电子工程师的时间。另外,可以讨论一些诸如PCB板是否需要隔离等重要信息。
将工作频率较快的元件放置在一起,甚至在某些情况下将这类元件放置在PCB板的两侧,从而避免出现时序问题。不幸的是,这类工作频率较快的元件产生的热功耗很大。因此,如果不进行相关的热设计工作可能带来灾难性的后果。譬如将过热元件置于来流经过的位置,这些微小地改动往往会带来良好的散热效果。
特别是在高功率密度的系统中,将多个元件的主轴与气流的主导方向成一直线是个不错的选择。因为它增加了流经PCB板的空气流量,并且减少了元件上方气流的旁通,从而增强了散热性能。
热设计中最大的挑战之一是获得元件正确的热功耗值。许多元件是连续工作的,所以正常工作情况下的平均功耗是我们所关心地,而非元件的名义或最大额定功耗。
热设计工程师、结构工程师和电子工程师之间相互交流散热相关的设计数据,并相互告知设计更新后的结果,这是企业热设计流程成熟的一个标志。随着设计不断推进,须不断和反复检查预测元件的功率,因为它们可能与原始值存在较大差异。
散热器扩大了元件和空气间的面积,但重要的一点是面积也不能过大。最佳的方法是选用成本最低的散热器,并且使元件温度低于额定设计值,同时包含一定的余量。更多的散热器翅片可以提供更多的散热表面积,但过多的散热器翅片也可能减少有效的散热面积。因为这可能增加流阻,导致气流旁通散热器,而不是流过散热器。
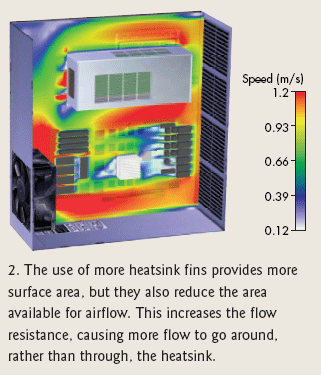
这一阶段应避免不切实际的想象。如果元件上方的气流流向主要是一个方向,使用与气流平行的平直型铝挤散热器。如果不是,或许机箱内存在可以提高气流流速的区域。如果气流与元件呈一定角度或者冲击元件,可以使用针状散热器。
包括风扇选择在内的其它方面的模型细化也应进行。专业电子散热的CFD软件具有风扇降额或自动计算风扇低速旋转的功能。这类软件通常都具有一个风扇电子库,并且可以直接将风扇模型拖入至仿真模型中。此外,风扇还可以具有串联或交替工作的功能。
详细设计阶段
结构设计完成之后意味着整个系统设计已经确定。但对于热设计而言还有两大工作需要完成。一方面是细化产品外壳模型,包括所有的风扇和通风口;另一方面是细化模型中的PCB和元件。对模型的细化工作将提高热仿真结果的准确性。
产品的热性能可能千差万别,设计所采用的热流路径也有多种选择,比如可以将元件热量导向PCB板进行散热或者将热量导向散热器进行散热。封装选择很大程度上取决于电子产品的性能和成本。如果将散热成本计入总成本的话,原料最便宜的封装方案可能成为总成本最高的方案。所以我们应该在封装材料选择过程中考虑热性能。
在热仿真初期采用块模型描述元件,这是非常粗糙的一种方法,所得到的元件结温也不够准确。与元件封装形式的选择相类似,元件的热仿真模型也至少更新为双热阻简化模型2。这将更为精确的预测元件的结温,双热阻模型由结点至上表面外壳热阻和结点至PCB热阻组成,当然能获取Delphi简化模型话最为理想3。
供应商提供Delphi模型的可能性很小。幸运的是,一种基于网络的工具能让系统设计者通过芯片封装外形尺寸创建各种芯片的双热阻模型和Delphi简约热模型4。如果供应商无法提供其他相关信息,但只要清楚芯片的尺寸同样可以进一步提高模型的准确性。此外,也可以创建内部具有详细结构的封装模型。
在PCB布局完成之前应确定散热器设计方案。如果散热器底部尺寸大于元件尺寸,则应在PCB上方余留一定空间。散热器会加大系统内空气流阻,因为流经散热器后方元件的空气流量变小,所以位于散热器后方的元件很可能温度会升高。因此,布局可能需要做一些调整。
散热器成本与其重量有很大关系。因而,便宜就意味着轻,从可靠性的角度来看这也是所希望的。重的散热器对元件产生更大的应力,并且需要在PCB上增加扣件。一些专业的电子散热CFD软件具有强大的网格技术,可以自动优化散热器的设计,最小化重量以达到指定的目标温度5。如果散热器表面积以最小程度扩大,也许热传导良好的塑料材质散热器就能够达到散热的需求。
在PCB布局结束之前,热设计应达到完全有信心将元件的温度控制在额定值之下。此外,任何使用到散热器的元件,其使用的散热器也应完成优化设计。通常,在安排接下来的工作之前,我们都是期望PCB板的设计已圆满完成。
PCB板的仿真模型可以进一步的细化,每一层的含铜量(比如,信号层含铜量20%, 电源层和接地层为90%)并将这些含铜量分别在模型中进行设置,可以提升PCB的仿真结果精度。如果PCB的走线已经完成,从EDA接口中导入详细的走线信息,可以进一步地提升热仿真结果精度。这可以考虑每一层铜的分布以及各层之间的热过孔。
系统模拟
在建立第一个样机之前,通常都会进行一个专门的、高度详细的热验证仿真(Fig. 3)。如果在设计的早期就考虑了散热热问题,那么最后的验证将是建立样机之前的一个流程而已。也许,在早期考虑散热问题已成为一个成熟热设计流程的标志。
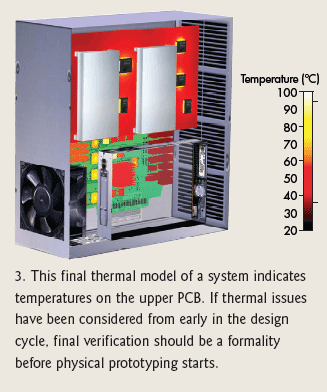
具有完善热设计流程的公司能将热设计贯穿于项目的整个研发过程中,并在概念设计阶段就考虑到了散热问题。公司也能汲取大量的经验教训。应用这些经验可以提升产品的性能,同时也能够优化元件热仿真模型,并且找到进一步改进热设计流程的方法。
参考文献
1. “Sense and nonsense of heat transfer correlations applied to electronics cooling,” Lasance, C.J.M., Proceedings of the 6th EuroSimE Conference, 18-20 April 2005, pp. 8-16
2. “Two-Resistor Compact Thermal Model Guideline,” www.jedec.org/download/search/JESD15-3.pdf
3. “DELPHI Compact Thermal Model Guideline,” www.jedec.org/download/search/JESD15-4.pdf
4. www.mentor.com/products/mechanical/products/flotherm-pack
5. “Simulation-based design optimization methodologies applied to CFD,” Parry, J., Bornoff, R., Stehouwer, P., Driessen, L., Stinstra, E., Proceedings of 19th SEMI-THERM Symposium, 11-13 March 2003, pp. 8-13









 沪公网安备 31010602003953号
沪公网安备 31010602003953号